이재용 삼성전자 부회장이 삼성전자 2분기 실적 발표일인 차세대 반도체 패키징 기술개발 로드맵을 점검했다. 패키징은 반도체 후공정 과정에서 핵심을 차지하는 기술로, 2030년까지 시스템 반도체 분야 세계 1위를 선언한 삼성전자로선 필수적으로 가져가야 하는 분야로 평가받는다.
삼성전자는 이재용 부회장이 30일 천안 온양사업장을 찾아 차세대 반도체 패키징 기술개발 로드맵 등 중장기 전략을 점검한 뒤 임직원 간담회를 했다고 전했다.

이날 자리에는 김기남 삼성전자 부회장, 진교영 메모리사업부장 사장, 정은승 파운드리사업부장 사장, 강인엽 시스템LSI 사업부장 사장, 박학규 경영지원실장 사장 등이 참석했다. 이 부회장이 온양사업장을 찾은 건 지난해 8월 이후 두 번째다.
이 부회장의 온양사업장 방문은 시스템 반도체 1위 도약이라는 목표를 이루겠다는 의미로 풀이된다.
온양사업장은 차세대 패키지 기술을 개발하는 곳이다. 삼성전자는 2018년 말 패키지 제조와 연구조직을 통합해 TSP(Test & System Package) 총괄조직을 신설했고, 지난해 삼성전기의 PLP사업부를 인수한 데 이어 온양사업장 내 LCD 라인을 걷어내고 PLP라인 2개를 설치한 뒤 FO-PLP를 개발 중이다.
삼성전자 온양사업장, 차세대 패키징 'FO-PLP' 담겼다
반도체 기술력을 설명할 땐 다소 복잡한 용어들이 혼재된다. 그런 만큼 이를 이해하기 위해선 반도체 공정과정을 이해할 필요가 있다.
반도체 공정은 크게 전공정과 후공정으로 이뤄진다. 전공정은 웨이퍼 위에 반도체 회로를 가공하는 방식이다. 후공정은 이를 잘라 하나의 독립된 반도체 소자로 만든 뒤 배선을 정리하고 포장하는 과정이라 보면 된다. 후공정 중 가장 핵심이 되는 공정이 바로 ‘패키징’으로, 반도체와 제품 간 전기적 통로가 됨과 동시에 1차 포장을 하는 역할이 포함된다.
스마트폰의 등장으로 제품 사이즈가 작아지면서 반도체도 크기가 줄고, 이에 패키징에도 기술이 요구되고 있다. 예컨대 예전엔 단일 칩만 들어가던 데서 나아가 여러 칩을 쌓거나 애플리케이션 프로세서(AP)나 낸드플래시, D램 등을 한꺼번에 넣고 멀티칩 패키징이 가능해진 것이다. 이를 SIP, 즉 시스템 인 패키지(System-In-Package)라 부른다.
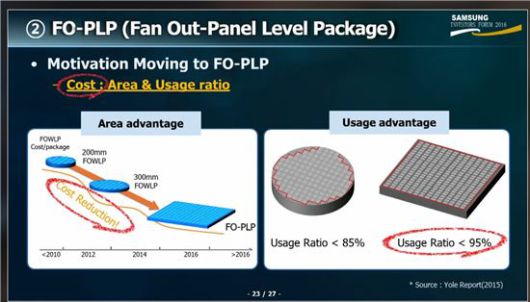
최근 삼성전자가 밀고 있는 차세대 패키징은 여기서 좀 더 나간다. 팬아웃-패널레벨패키징(FO-PLP)라 부르는 기술을 온양사업장에서 개발 중인데, 팬 아웃은 입출력 단자 배선을 칩 바깥으로 뺀다는 뜻이며 패널레벨패키징은 사각형 패널 단위로 패키징하는 것을 뜻한다.
이 기술은 칩 위에 여러 시스템들을 얹던(시스템 온 칩·SOC) 데서 나아가 기판 없이 네트워크와 연동(시스템 인 칩·SIC)되는 패키징 기술이다. FO-PLP는 TSMC가 채택한 ‘팬아웃-웨이퍼레벨패키지(FO-WLP)’보다 생산성이 높다는 평가를 받고 있다.
패키징은 시스템반도체 1위 향한 삼성전자 첫 관문
FO-PLP가 범용화되면 반도체 성능도 늘겠지만 두께가 얇아지는 효과도 낳는다. 이 같은 변화는 생각보다 더 큰데, 우리가 생각하는 전자기기의 인식 자체를 바꿔버릴 수 있을 정도다. 전자기기들의 크기가 작아질 뿐만 아니라 기계 자체의 형태를 바꾸는 것도 가능해지기 때문이다.
갤럭시 폴드와 같은 폴더블폰을 이해하면 쉽다. 삼성전자가 처음 폴더블폰을 상용화했을 때, 대다수 사람들은 ‘폴더폰도 아니고 뭐하러 폴더블 폰을 내느냐’는 반응을 냈는데, 이는 다양한 디바이스 형태를 내기 위한 초기 기술적 성과로 보는 게 적절하다. 이 기술이 더 발전하면 디바이스를 단순히 접는 걸 떠나 옷 입듯(웨어러블) 입게 될 수도 있다.
다시 본론으로 돌아오자. 패키징 기술은 결국 반도체 안에 다양한 시스템을 얹는 핵심 기술이라는 점에서 시스템 반도체 성장의 핵심이 된다. 삼성전자는 그간 패키징보단 전공정에 관심을 뒀는데, 이는 메모리 반도체 분야에서 세계 1위를 독주하는 데 기여했지만, 반대로 시스템 반도체 분야에선 기술력이 뒤처지게 만든 요인이 됐다.

이에 삼성전자는 시스템 반도체를 강화하는 데 열을 올려왔고, 지난해에는 ‘반도체 비전 2030’을 통해 시스템 반도체도 세계 최고의 지위를 갖겠다고 선언한 상태다. 만약 차세대 패키징에서 업계 최고 수준의 기술력을 갖게 된다면 삼성전자는 파운드리 측면에서도 분명한 강점을 갖게 된다. 고객사에 제공할 패키지 기술이 늘어나기 때문이다. 업계 선두인 대만 TSMC의 파운더리 점유율을 뺏기 위한 '초석'이 될 것임을 짐작할 수 있다.
무엇보다도 삼성전자의 2분기 실적이 발표되는 30일 이재용 부회장이 온양사업장을 찾았다는 것에 분명한 의미가 있다. 향후 10년 앞을 내다본 삼성전자의 시스템 반도체 시장 공략이 성공할지에 패키징 기술 개발이 적지 않은 역할을 하게 될 전망이다.

